电话
0596-6011789

无铅焊接除了銲料(Solder)必须全部禁铅外,PCB电路板板面(含各式封装载)之焊垫、通子L焊环以及零件脚等各种表面处理,也都必须无铅。先就板面焊垫而书,其真正可供量产选择的可焊处理,预计将有下列七八种,而具正能上线量产者,目前看来则仅有OSP与I-Sn或I-Ag两三种而已。
至于零件脚或接垫的可焊表面处理,除了早期各式IC金属脚架(LeadFrame,亦称导线架),系採用卷带收放式(ReeltoReel)连续电镀外,其馀散装元件(Discrets分离式为拙译)不管是被动或主动者,则多半採用“滚镀”(Barrelplating)的大量处理方式,现行及未来之主流槽液将有:
1、电镀纯锡(以酸性硫酸亚锡TinSulfate或甲基磺酸锡为槽液,可兼做挂镀或滚镀,此种铜材之表面镀锡又可分为光亮锡及雾面锡两种,前者容易发生锡鬚,后者价格较贵。)
2.电镀银Silverplating(以硷性氰化物槽液为主,亦可兼做挂镀及滚镀两种方式。)
3.电镀镍与锡NickelandTinplating(将铜材表面先镀上一层镍,再镀纯锡者,将可减少锡鬚的问题。)
4.其他尚有电镀镍锂(Ni/Pd),与电镀镍镀金(Ni/Pd/Au),甚至电镀其他各种锡合金等,然而在成本太贵或技术成熟度不足两方面的缺失下,目前尚不足形成气候,将不再介绍。
简单的说OSP就是在洁淨的裸铜表面上,长出一层有机皮膜,用以保护铜面处于常态环境中不再继续生鏽(氧化或硫化等);但在后续的焊接高温中,此种保护膜又必须很容易被助焊剂所迅速赶走清除,如此方可使露出的乾淨铜面,得以在极短时间内得与熔融銲锡立即结合成为牢固的銲点,此等可护铜抗锈的有机皮膜,一律称之为”有机保护膜剂”(OrganicSolderabilityPreservatives)。
早期某些含松香(Rosins)或活性树脂(ActiveResins)类,所配製的各种涂佈式预焊剂(Preflux),即为此类OSP之先期产物。不过昔时单面板领域常称为”整面处理”(整理铜面),是在铜面上涂佈上的一层物理性的有机保护膜;与后来美商Enthone公司首先利用坐类(Azole)化学品,与铜面直接反应而生成”有机铜络化物”的化学性保护膜,在原理上并不完全相同,但护铜保焊的效果上却很类似,故目前也一律称之为OSP。
Enthone企司利用Azole化学品(例如Benzo-Triazole)对铜面的保护技术,亦即业界知名的商品Entek,此乃出自IBM当年所最早使用的CU-56的暂时水性护铜剂。此种OSP经过多年的历练与改善,目前已有长足的进步,将来可能成为无铅焊接时代,板面焊垫暨便宜又平坦的主要处理方法。
此BTA可使铜面免于腐蚀与氧化的护铜方法,可追溯到1960年代IBM在其PCB製程中,保护铜面的暂时性皮膜CU-56(1%的BTA水溶液),后经供应商Enthone公司的继续研究改进,而成为知名的Entek处理法(EnthoneTechnology)。以至目前仍有极多业者只晓得有Entek的商名,而不知有BTA的鼻祖学名。
BTA之所以能抗蚀护铜的原理,是因与铜材表面的氧化亚铜Cu20进行立即直接的反应,进而生成高分子状态有机铜式之错合盐类(Complexor太陆译为络合剂,比道接引用日文的错合剂者,似要更为高明),下式即为其反应过程的示意结构,亦即于铜面形成多重薄膜的假想图。此等BTA与氧化亚铜(Cu20)所形成的皮膜,属牛透明性无色的皮膜(老化后变成褐色),在槽液中将会不断长厚,与温度、时间、pH等有关。1989年会有学者Tornkvist等人在”电化学学会期刊”发表专文,指出当BTA分子与氧化亚铜首先进行反应的瞬间,BTA会以其分子中”三连坐之特殊方向性(Orientation)产生互动,并令其朝外而生成[Cu(I)BTA)n的长鍊,再配合其他吸附的机理下,即可形成平面状分子膜而附著在铜面上。
以下为1996年6月“电路板资讯杂志”之P.80对于护铜剂BTA之文字解说:
所谓的BTA是Benzotriazole的缩写,其正式学名为1,2,3-Benzotriazole,是指在1,2,及3位处有三个互相连接的偶氮,并形成5个碳的杂环化舍物,称为“含氮之杂戊环”或称吐系(Azole)之苯化物。
BTA是一种白色带淡黄,无嗅之晶状细粉,在酸及硷液中都非常安定,且也不易发生氧化及还原反应而相当安定。能与金属形成安定的化舍物。此BTA不易溶于水,但能溶于醇类或苯类中通常可做为照片的保护膜或紫外线吸收剂。
十余年前美国著名的电路板化药供应商Enthone公司,将之溶于甲醇及水的溶液中出售,做为铜面的抗污抗氧化剂(tarnishandoxideresist},商品名为ENTEKCU-55及CU-56,并得IBM的认可。后各的名气很大,在国内多数电路板厂多用其0.25%之稀水溶液当成护铜剂,在厚化铜完成后,只毕将板子浸入槽液30-60秒处理,然后以热风吹乾即可得到良好的护得效果,无需再做刷磨而可直接完成影像转移的工作(乾膜或印刷皆可),在进入二次铜前的稀硫酸活化清洗时,即可很容易将之除去,有助于铜与锦之间的结合附著力。
其高浓度(l%)的槽液浸渍处理,对裸铜的保护性更强,其至可代替喷鍚板(SMOBC)能做长期的护铜,对板子在装配时的焊锡性表现,比之熔鍚、喷鍚、滚锡各褽程亦不遑多让。本文即为IBM之研究专文,在“减废”观念渐盛,及电路板成本被逼降的今日,特将该全文漫译以飨读杏,做为製程改进的参考。
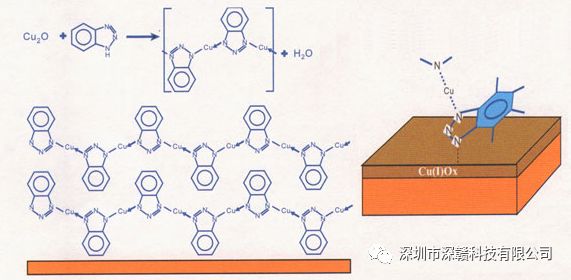
若将上违BTA分子式三连氮的五角环的l位与2位t见前图l,处,另外替换上其他的官能基时(例如甲基),则比起原始BTA的抑制效应要减低若干。但将六角苯环中的4与5位的氢原子,替换上甲基(Methyl)时,则又比起原始BTA的抑制效果却又增大了一些,如此一来一往的变化,将会使得皮膜在铜面上的吸附力更强,其抑制力强弱的顺序可排列为:
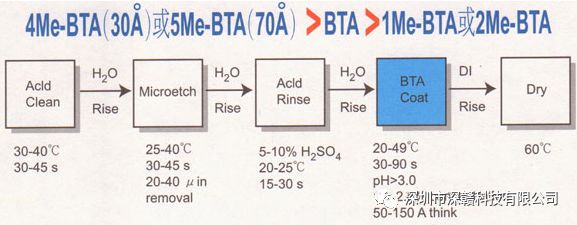
由此等流程所得到的铜面保焊剂,厚度约40-140A(IA=O.lnm或1nm=10A),在乾燥空气中的保固寿命可达2年。但在高溼度的环境中,却只能忍耐3-6个月而已。此种BTA式的铜面暂时性抗氧化保护剂,由于不耐高温环境,根本无法进行2-3次或多次焊接,而且金手指表面上也会长出不该有的OSP皮膜,太厚时更将使得接触导通(Contact)曼阻,或造成电测的困扰,目前已从可焊处理清单中淘汰除名,
此类第二代化学品常用者为“烷基咪唑”(Alkylimidazoles),也可与氧化亚铜进行反应而形成高分子状的络合物皮膜,目前本类仅做为单面板预焊剂(Preflux)之用。下两图即分别为其结构式,及在铜面反应所生成有机铜高分子保护膜的示性过程。

图3、左为烷基咪坐的结构式。右为与铜面反应后所生成有机铜式的护铜薄膜结构图。
此种OSP平均厚度很薄,只有IOOA(lOnm)而已,故不耐高温的考验,温度愈高时保护性愈差,原因是铜面发生氧化的机会也愈大之故。下图即为其高温劣化后出现氧化铜并以其厚度为指标,比较其焊锡性的下降情形。故本剂配方者亦无法进行多次高温焊接。

图4、咪唑式护铜皮膜对高温非常敏感,在经150℃四小后氧化膜已厚达15μm,至于200℃经2小时者就更增加到22~23μm之厚皮膜,此时当然无法继续使用免洗锡膏去焊接了。
图 6、此为四国化学改革后的SBA式第四代护铜膜,其机理与先前者很相似,此假想图即为其铜面OSP保护膜的多层次结构图。
图7、此图说明OSP在铜面快速成长过程中,也会在金面上缓慢着落,第四代后期几乎可完全通过目检二不必擦洗了
图10、此为先前美商Enthone所说明商品EntekPlus106A的皮膜结构,其中官能团胺基中的氮原子(N)首先与铜发生络合反应,一旦铜面遭到污染时则反应就不易发生了。而被酸性槽液所溶出的铜离子,又会再被络合剂所抓住,而形成后绩有机金属式多孔性的皮膜组识,如此不断反应增厚,即可形成浅棕色的皮膜。
图11、上列四图为Enthone公司特别为Entek Plus 106A处理后铜面所提供目检对比的彩色画面。
上一篇:什么是电路板OSP及OSP的优点
下一篇:没有了
